325nm励起による半導体材料の局所発光波長分布の評価
フォトルミネッセンス(PL)イメージングは、GaNの発光特性やワイドギャップ半導体の欠陥、不純物の分布評価に広く用いられています。ナノフォトン社製レーザーラマン顕微鏡にオプションの波長325nmのUVレーザーを搭載することで、In組成やサイズが異なるInGaNドットや、GaNなどワイドギャップ半導体材料のPLスペクトルの検出ができます。
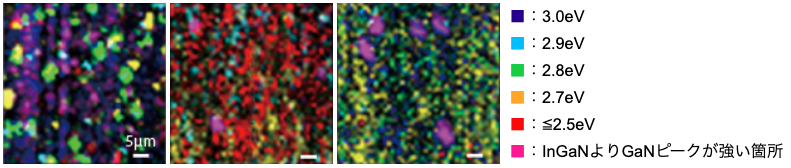
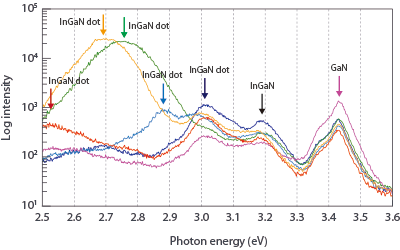
| 励起波長 | 325 nm |
| 対物レンズ | 40倍 (NA=0.50) |
| 回折格子 | 300 gr/mm |
| スペクトル数 | 2,500 (50×50) |
| 測定時間 | 34分 |
InGaNおよびInGaNドットの代表的な室温PLスペクトル
サファイア基板上GaN上に作製した、InGaN層のPL測定の結果を上の図に示します。このサンプルでは、結晶成長の際に、Inに関する成長条件を変化させてInGaNを結晶成長させており、条件の違いによりIn組成やサイズが異なるInGaNドットの分布が観察されています。PL画像上の色の違いは、ドットの種類(PLのピーク波長)に対応しています。微弱光の検出用に設計されたRAMANtouch/RAMANforceでは、原子レベルの小さなドットでも検出し、その分布(位置)が観察できます。また、数百nmの空間分解能を有するため、それより大きいドットではその大きさの評価が可能です。ナノフォトン社製レーザーラマン顕微鏡は、半導体の局所的な組成分布を可視化できる有効なツールです。
※このサンプルは、東北大学 金属材料研究所 松岡研究室様よりご提供いただきました。
紫外光の浅い侵入長を生かしたSiC最表面の応力のラマンイメージング
UVレーザーは、可視レーザーと比較して浸入長が浅いため、結晶の最表面のラマンスペクトルを選択的に取得することができます。シリコンを例にとると、532nm励起では約400nm、355nmでは約5nm深さの評価が可能です。
紫外レーザーを用いたSiC最表面における応力分布

励起波長:325nm
対物レンズ:40倍(N.A.=0.50)
